玻璃基板并不是一个新概念,近十年来,最小的芯片、晶圆级芯片规模 (WLCS) 组件一直使用玻璃基板。在这种外形尺寸中,BGA球栅阵列焊球直接安装在 IC 晶圆上,然后以倒装芯片方式将电路面朝下安装,顶部有保护玻璃基板。
使用此封装系统的一些更常见的芯片是电源组件,例如稳压器和转换器。这些部件中最小的部件只有几毫米见方,但由于通过焊球和作为散热器的玻璃基板有更直接的热路径,因此可以处理与大型 TO-220 外形尺寸相同的功率。
无论是在制造阶段还是在最终应用中,玻璃作为基材都比更传统的材料具有许多优势。现在,英特尔希望通过新开发的大型玻璃基板技术,将这些热性能和其他改进的基板特性带到其******的芯片中。
允许更密集小芯片互连
许多新的、最高性能的芯片是使用多个小芯片开发的,而不是作为单个单片硅片。这称为系统级封装架构或分解设计。这样做可以在相同的物理空间中实现更高的产量、更大的制造灵活性和更强的计算能力。
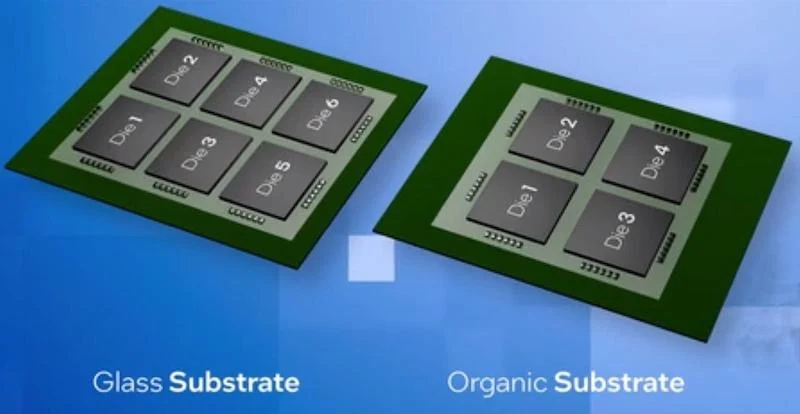
尽管如此,当前的有机基材类似于高温印刷电路板 (PCB)对于制造工艺和遇到的操作温度来说不够稳定。
有机基材可能会随着温度升高而变形或降解。本质上,有机基质正在达到其尺寸限制。玻璃能够承受更高的温度而不会变形或降解。这样可以实现更密集的间距,在相同的封装面积中可以多出 50% 的小芯片。
同时,这些小芯片需要高速互连才能作为单个单元运行。玻璃比有机材料具有更光滑的表面,并且具有更接近硅晶片的热膨胀特性。
更光滑的玻璃表面将为互连提供更严格的设计规则更小的迹线和空间。玻璃在较高的最高工作温度下具有更高的稳定性,可将光刻图案变形减少 50%。最终结果是互连密度提高了 10 倍。
用于人工智能和数据中心应用的高功率 CPU 的散热是服务器群功耗的主要领域之一。它还限制了大型单片芯片的处理速度。
转向小芯片布局允许处理器各部分之间存在热间隙。该空间还可用于更有效地向各个分区提供电力。这两个优点都允许更高的速度和更低的功耗。
渗透到主流应用程序
基于小芯片的 IC 的应用远远超出了数据中心和高端应用的范围。英特尔最新的Meteor Lake笔记本电脑 CPU 采用小芯片构建,可减轻 CPU 的耗电功能。它具有多部分英特尔称为“tile”架构,将小芯片分组以用于低功率工作、高功率计算密集型工作和图形。
Meteor Lake没有使用玻璃基板,但它使用了chiplet架构,未来的处理器将大大受益于新的玻璃基板技术。
英特尔相信,凭借更多的小芯片、更好的电力传输和更高速度的互连,功耗的降低和密度的提高将使到本世纪之交能够将一万亿个晶体管装入一个封装中。英特尔希望利用这一能力来惠及自己的 IC 制造和代工服务业务。
SI3457CD品牌:Vishay/威世年份:2022产地:中国SI3457CD标签验标回复遴选:1、邓润华:标签无异常,可以2、···
GRM31CR61C476ME44L品牌:Murata/村田年份:2021产地:日本GRM31CR61C476ME44L标签验标回复遴选:1、邓润华···
BMI270品牌:Bosch Sensortec/博世传感年份:2024产地:菲律宾BMI270标签验标回复遴选:1、邓润华:博世标签···
STM32G031K8U6品牌:STMicroelectronics/意法半导体年份:2024STM32G031K8U6标签验标回复遴选:1、邓润华:···
DG9431DV-T1-E3品牌:Vishay/威世年份:2005产地:中国DG9431DV-T1-E3标签验标回复遴选:1、邓润华:标签无···
···
CW2217BAAD品牌:CEllWISE/赛微年份:2024CW2217BAAD标签验标回复遴选:1、邓润华:可以2、方洪涛:看好3、···
FODM3063R2年份:2021产地:中国FODM3063R2标签验标回复遴选:1、方洪涛:看标没事2、黄德华:仙童的,整体···
1050281001品牌:Molex/莫仕年份:2022产地:中国1050281001标签验标回复遴选:1、邓润华:工厂标签,可以2···
TPS63060DSCR品牌:Texas Instruments/德州仪器年份:2021产地:马来西亚TPS63060DSCR标签验标回复遴选:1、···
MAX20402AFLE/VY+T品牌:Analog Devices/亚德诺年份:2023产地:中国台湾MAX20402AFLE/VY+T标签验标回复遴选···
TB67H45FNG品牌:Toshiba/东芝年份:2022TB67H45FNG标签验标回复遴选:1、方洪涛:看货为主,标重打,但不是···
HPG12P14SRT153T品牌:Amphenol Advanced Sensors年份:2020产地:中国HPG12P14SRT153T标签验标回复遴选:1···
···
···
MIMX8MM6DVTLZAA品牌:NXP Semiconductors/恩智浦年份:2023MIMX8MM6DVTLZAA标签验标回复遴选:1、供应商判···
A1393SEHLT-T品牌:Allegro/急速微年份:2024产地:中国A1393SEHLT-T标签验标回复遴选:1、黄德华:可以2、···
B82793C0475N265品牌:TDK EPCOS年份:2023产地:中国B82793C0475N265标签验标回复遴选:1、方洪涛:看可以···